레이저 어블레이션과 Xe 플라즈마 FIB-SEM의 결합: 반도체 산업의 대규모 물리적 고장 분석에서 정밀한 엔드포인팅을 위한 접근법
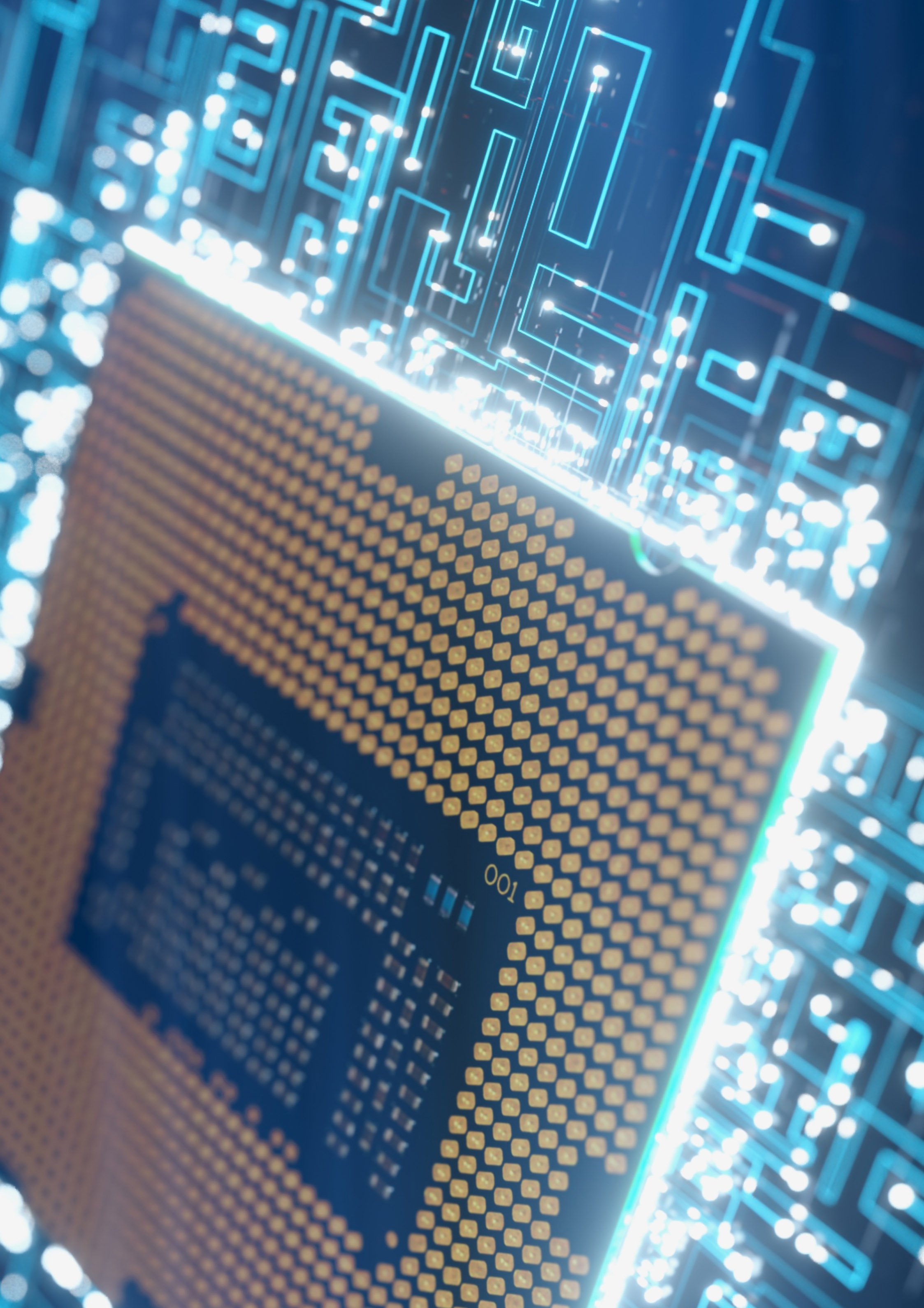
고장 분석을 위한 시료 준비에 드는 시간과 비용을 줄이고 싶으신가요?
로드리고 델가디요 블란도(Rodrigo Delgadillo Blando) 등이 발표한 "레이저 어블레이션과 Xe 플라즈마 FIB-SEM의 결합: 반도체 산업의 대규모 물리적 고장 분석에서 정확한 엔드 포인팅을 위한 접근법"은 2021년 ISTFA 컨퍼런스에서 발표된 논문으로, ps 레이저 어블레이션 툴과 Xe 플라즈마 FIB-SEM 시스템을 사용하여 마이크로 전자 소자의 대면적 단면을 준비하는 혁신적인 방법을 기술하고 있습니다. 이는 마이크로전자 소자의 고장 분석의 효율성과 정확성을 향상시키는 것을 목표로 하는 매우 관련성이 높은 최첨단 연구입니다.
저자들은 물리적 고장 분석(PFA)을 위해 마이크로전자 장치의 깊숙이 묻혀 있는 구조에 접근하는 것과 관련된 문제를 해결합니다. 기계적 연마나 Ga+ FIB 밀링과 같은 기존 방법은 너무 느리거나 너무 손상되어 대량 샘플 준비에 적합하지 않습니다. 이 논문은 ps 레이저 제거 도구의 빠른 재료 제거 속도와 Xe 플라즈마 FIB-SEM 시스템의 정밀한 엔드 포인팅 및 미세 표면 연마 기능을 결합한 방법을 제안합니다. 이 논문은 이 방법을 사용하면 두 툴을 동시에 연속적으로 작동할 수 있어 생산성을 높일 수 있을 뿐만 아니라 마이크로 전자 소자의 빠르고 정확한 PFA가 가능하다고 제안합니다.
 이 연구는 민감한 재료와 복잡한 구조로 구성된 AMOLED 모바일 디스플레이의 손상 및 박리 없는 단면을 준비하는 등 다양한 애플리케이션에서 제안된 방법의 효과를 입증합니다. 이 논문에서는 고해상도 이미징 및 분석이 필요한 다양한 솔더 볼 재질과 크기를 가진 플립칩 패키지의 단면 준비와 엔드 포인팅을 위한 CAD 탐색, 데이터 상관관계 및 비트맵 오버레이에 대해서도 설명합니다. CAD 탐색, 데이터 상관관계, 엔드포인팅을 위한 비트맵 오버레이.
이 연구는 민감한 재료와 복잡한 구조로 구성된 AMOLED 모바일 디스플레이의 손상 및 박리 없는 단면을 준비하는 등 다양한 애플리케이션에서 제안된 방법의 효과를 입증합니다. 이 논문에서는 고해상도 이미징 및 분석이 필요한 다양한 솔더 볼 재질과 크기를 가진 플립칩 패키지의 단면 준비와 엔드 포인팅을 위한 CAD 탐색, 데이터 상관관계 및 비트맵 오버레이에 대해서도 설명합니다. CAD 탐색, 데이터 상관관계, 엔드포인팅을 위한 비트맵 오버레이.
이 논문에서는 CAD 탐색, 데이터 상관관계, 엔드포인팅을 위한 비트맵 오버레이와 같은 관련 문제도 다룹니다. 이 논문은 제안된 방법이 최소한의 아티팩트와 손상으로 고품질 단면을 생성하고 균열, 보이드, 금속 간 화합물 및 박리와 같은 결함을 밝혀낼 수 있음을 보여줍니다.
테스캔 솔루션으로 반도체 고장 분석을 최적화하세요: TESCAN 솔루션으로 IC 패키징 불량 분석 마스터하기
이 매력적인 연구에 대해 알아보세요: 레이저 어블레이션과 Xe 플라즈마 FIB-SEM의 결합: 반도체 산업의 대규모 물리적 고장 분석에서 정확한 엔드포인팅을 위한 접근법 | ISTFA Proceedings | ASM 디지털 라이브러리(asminternational.org)
테스캔 솔루션으로 반도체 고장 분석을 최적화하세요: TESCAN 솔루션으로 IC 패키징 불량 분석 마스터하기

최신 반도체 기술 알아보기
업계 전문가, 연구자 및 학계와 함께 반도체의 미래를 탐구해 보세요. 당사의 전문가 팀은 업계 전문가, 연구자 및 학계와 교류하여 귀사의 요구 사항을 파악하고 TESCAN의 솔루션이 귀사의 연구 개발 이니셔티브를 어떻게 지원할 수 있는지 논의할 수 있기를 고대하고 있습니다.
