마스터 IC 패키징
불량 분석
TESCAN 솔루션 사용
플라즈마 FIB-SEM의 힘 경험하기
및 혁신적인 TESCAN 대면적 워크플로우
새 논문
반도체 불량 분석 최적화: 레이저 절삭과 Xe 플라즈마 FIB-SEM 결합의 힘
플라즈마 FIB-SEM과 결합된 독립형 ps-laser 절삭의 잠재력을 최대한 활용하면 마이크로 전자 소자의 불량 분석을 그 어느 때보다 빠르고 정확하게 수행할 수 있습니다. 최신 논문에서 동시 연속 시스템 작동으로 생산성을 극대화하는 방법을 알아보세요!

반도체가 발전함에 따라 IC 패키징 고장 분석 연구소는 전례 없는 도전에 직면해 있습니다. 복잡한 반도체 불량 분석 요구, 진화하는 패키지 아키텍처, 축소되는 기능, 이색적이고 민감한 재료의 출현을 해결하는 것은 엄청난 과제입니다. 한편, 글로벌 반도체 기업들은 정교한 통신 장치와 다양한 가전 제품을 위한 최첨단 칩, 패키지, 칩렛을 개발하기 위해 경쟁하고 있습니다.
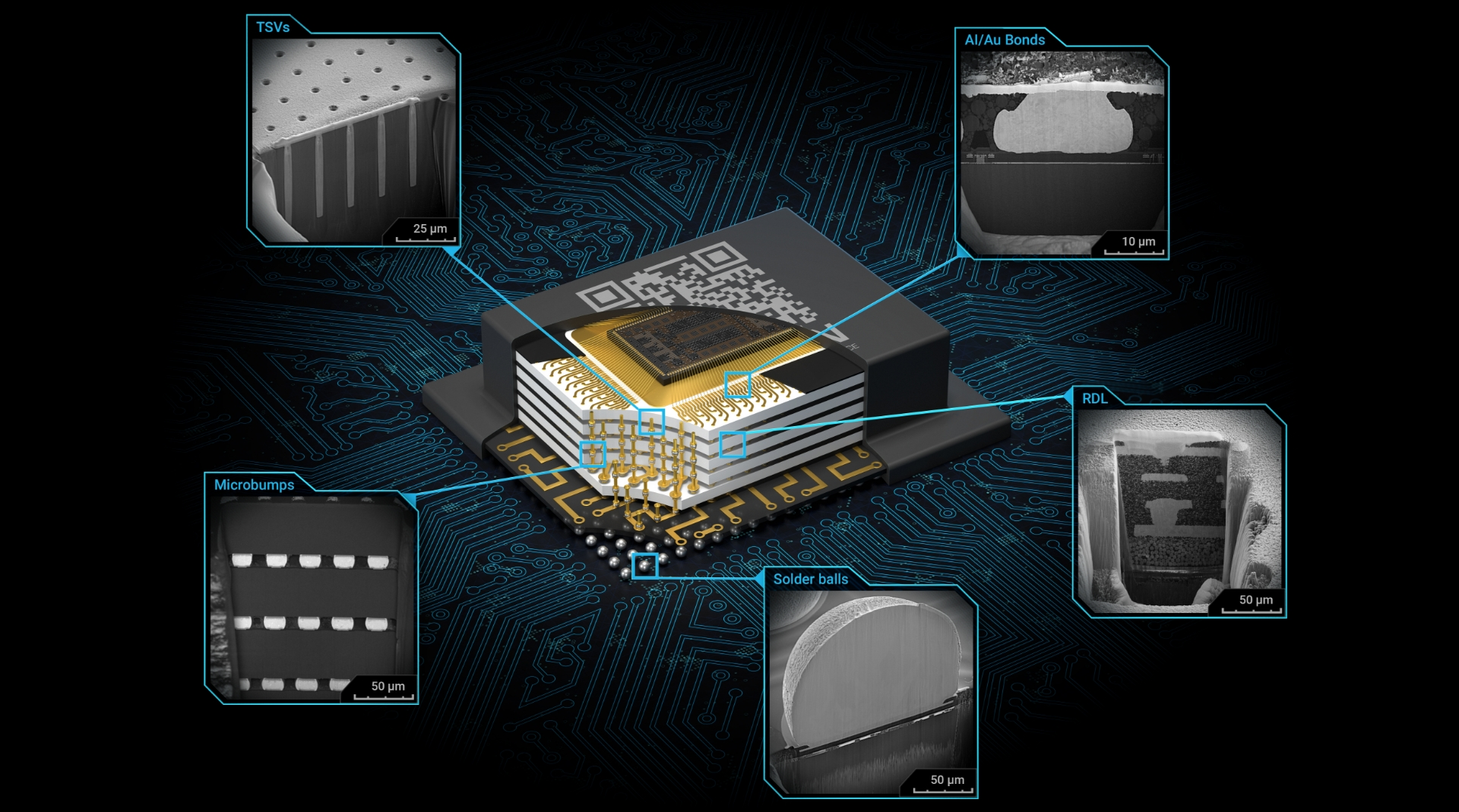
최첨단 TESCAN 솔루션으로 지속 가능한 IC 패키징 불량 분석의 혁신
지속 가능한 IC 패키징 불량 분석은 다양한 전문 지식과 FA 툴이 제공하는 광범위한 비파괴 및 파괴 과정에 달려 있습니다. TESCAN은 비파괴 마이크로-CT 고장 분석 애플리케이션, 플라즈마 FIB-SEM SOLARIS X, 레이저 절삭과 플라즈마 FIB-SEM 기술을 완벽하게 결합한 대면적 워크플로우 등 혁신적인 솔루션으로 고객을 지원합니다.
또한 TESCAN은 유럽 파트너들과 협력하여 수많은 불량 분석 장비들 사이에서 보다 원활한 불량 분석 워크플로우와 마이크로 일렉트로닉스 고장 분석 실험실의 디지털화를 위한 데이터 관리를 구축하기 위한 프로젝트인 FA4.0의 일환으로 협력하고 있습니다. 인사이트 섹션에서 FA4.0에 대해 자세히 알아보세요!
이러한 솔루션이 어떻게 새로운 차원의 IC 패키징 불량 분석을 지원하는지 직접 확인해 보십시오.
최첨단 솔루션 알아보기
테스칸 FIB-SEM 살펴보기
IC 패키징 불량 분석에서 심층 단면 분석 및 고해상도 엔드포인팅을 위한 최고의 플라즈마 FIB-SEM 플랫폼을 경험해 보십시오.
대면적 워크플로우 살펴보기

밀리미터 단위의 시료 전처리 및 분석을 위해 플라즈마 FIB-SEM와 독립형 레이저와 기타 FA 툴의 시너지 효과를 활용하세요.
질문이 있으신가요?
가상 데모에 관심이 있으신가요?
키사이트의 글로벌 팀은 반도체 및 IC 패키징 불량 분석을 위한 TESCAN FIB-SEM 및 솔루션에 대한 질문에 답변할 준비가 되어 있습니다.
